製品情報
型式:IM4000II
日立イオンミリング装置のスタンダードモデルであるIM4000IIは、断面ミリングと平面ミリング(フラットミリング®*1)に対応しています。冷却温度調整機能や雰囲気遮断ホルダユニットなど、各種オプションにより、さまざまな試料の断面試料作製が可能です。
*1フラットミリングⓇは、日本国内における株式会社日立ハイテクの登録商標です。
IM4000IIは500µm/h*1以上の断面ミリングレートを実現したイオンガンを搭載しています。硬質材料の断面試料作製に有効です。
*1加速電圧6kV、マスクエッジからSiを100µm突出させて1時間加工した際の最大深さ
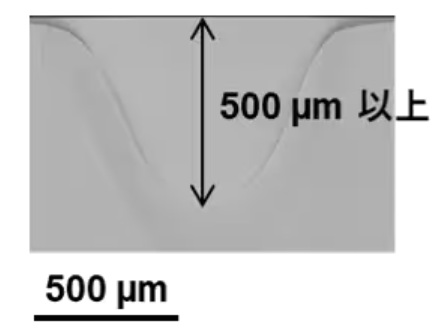
試料:Siウェハ(2mm厚)
加速電圧:6.0kV
スイング角度:±30°
ミリング時間:1時間
断面ミリング時のスイング角度が変わると、加工幅や加工深さが変化します。下図はSiウェハをスイング角度±15°で断面ミリングしたときの結果です。スイング角度以外は上記加工条件と同一です。上記結果と比べて加工深さが深いことがわかります。
深部に対象構造がある試料の迅速な断面作製には有効です。
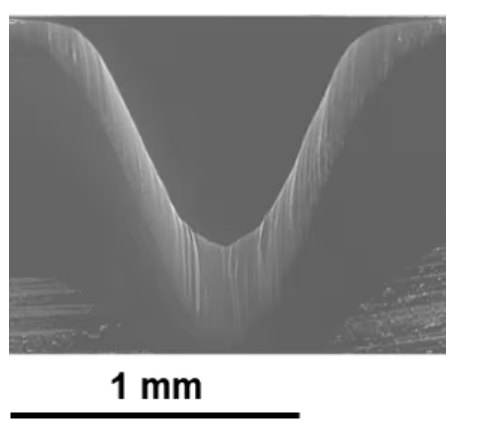
試料:Siウェハ(2mm厚)
加速電圧:6.0kV
スイング角度:±15°
ミリング時間:1時間
断面ミリング
断面ミリングの主な用途

平面ミリング(フラットミリングⓇ)
フラットミリングⓇの主な用途

デュワーに充填した液体窒素を冷却源として試料を間接冷却します。樹脂およびゴム系の試料の過冷却を防止する目的として温度制御する機能を搭載しています。

*1本体同時出荷オプションです。
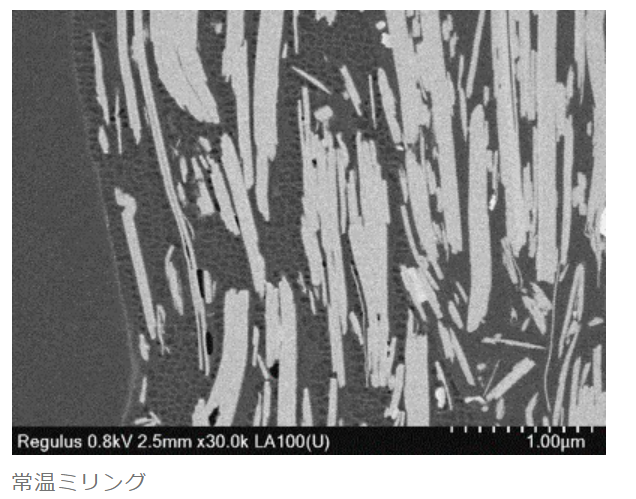
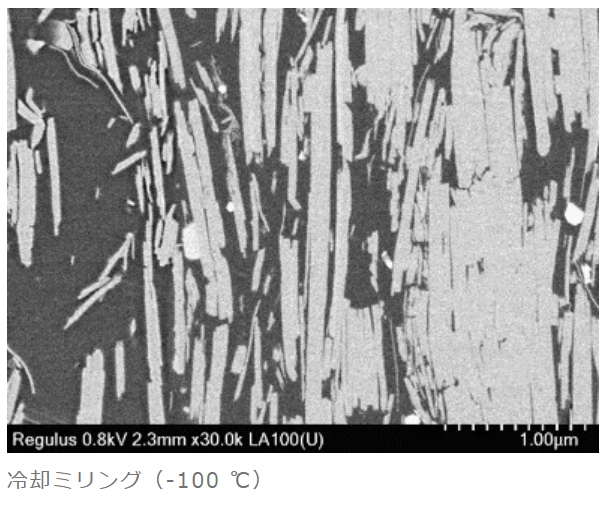
試料:プラスチックの使用量を抑える機能性材料(紙製)バリア素材
イオンミリング処理後の試料を大気暴露することなくSEM*1,AFM*2で観察するためのホルダです。本ホルダは冷却機能との併用も可能です(平面ミリングホルダは除く)。

*1雰囲気遮断試料交換室付きの日立FE-SEMのみ対応
*2真空対応日立AFMのみ対応
ミリング中の試料を観察できる実体顕微鏡です。CCDカメラが搭載できる三眼タイプではモニター観察が可能です。三眼タイプの他に双眼タイプも準備しています。

| 型式 | IM4000II |
|---|---|
| 使用ガス | Ar(アルゴン)ガス |
| Arガス流量制御方式 | マスフローコントローラー |
| 加速電圧 | 0.0~6.0kV |
| 外寸法(幅×奥行×高さ) | 616×736×312mm |
| 重さ | 53kg |
| 備考(重さ) | 本体53kg+ロータリーポンプ30kg |
| 断面ミリング:最大ミリングレート(材料Si) | 500µm/h*1 以上 |
| 断面ミリング:最大試料サイズ | 20(W)×12(D)×7(H)mm |
| 断面ミリング:試料移動範囲 | X ±7mm、Y 0~+3mm |
| 断面ミリング:イオンビーム間欠照射 ON/OFF時間設定範囲 |
1秒~59分59秒 |
| 断面ミリング:スイング角度 | ±15°、±30°、±40° |
| 平面ミリング:最大照射範囲 | φ32mm |
| 平面ミリング:最大試料サイズ | Φ50X25(H)mm |
| 平面ミリング:イオンビーム偏心量 | X 0~+5mm |
| 平面ミリング:イオンビーム間欠照射 ON/OFF時間設定範囲 |
1秒~59分59秒 |
| 平面ミリング:回転速度 | 1rpm、25rpm |
| 平面ミリング:スイング角度 | ±60°、±90° |
| 平面ミリング:イオンビーム照射角度 | 0~90° |
| オプション:冷却温度調整機能*2 | 液体窒素による間接試料冷却、温度設定範囲0~-100℃ |
| オプション:高ビーム耐性マスク(Co-Zero®)*3 | 当社標準マスク比で約2倍のビーム耐性マスク(コバルト不含有) |
| オプション:加工観察用実体顕微鏡 | 倍率 15×~100× 2眼タイプ、3眼タイプ(CCD対応) |